La-FMD ALD forløper for fremtidens ledende logikk- og minneprodukter
Sjeldne jordelementer har gått inn i høyvolumsproduksjon for avanserte logiske enheter siden 32 nm-noden (IBM, Samsung og Globalfoundries – Chipworks 2010). Spesielt for Lanthanum (La) - eponymet til lantanidserien i det periodiske systemet har blitt implementert som et dopingmiddel i høy-k metallportstabelen. Lantanoksid (La2O3, dielektrisk konstant ~ 27), for eksempel, har blitt utforsket i to tiår som et high-k gate dielektrikum for erstatning av konvensjonell silisiumdioksid (SiO)2) gate dielektrikum i neste generasjons transistorer i logikk så vel som i dynamiske tilfeldige aksessminner (DRAM).

Nøkkelordsegmentering av patentsøknader de siste 20 årene for Lanthanum og"Atomic Layer Deposition" [Patbase-søk 15. november 2018]
Atomisk lagavsetning er den mest lovende metoden for å dyrke ultratynne filmer av La-baserte gatedielektriske stoffer og har derfor vært under omfattende forskning og innlevering av patentsøknader de siste 20 årene. FoU-innsatsen har vært fokusert på felt relatert til dielektriske og høy-k dielektriske applikasjoner i halvlederindustrien (se nøkkelordsegmentering ovenfor). Den atomære lag-for-lag-filmveksten tilrettelagt av selvbegrensende overflatereaksjoner i ALD gir atomisk presis filmtykkelseskontroll, god ensartethet over et stort substrat, og utmerket konformalitet i tilfelle strukturer med høyt sideforhold som moderne FinFET-er og minnekondensatorer type søylestrukturer. For å fungere feilfritt krever det imidlertid ALD-forløperne som har spesifikke egenskaper (LINK):
1. Tilstrekkelig flyktig (minst ~ 0.1 Torr likevektsdamptrykk ved en temperatur der de ikke brytes ned termisk).
2. Rask fordampende og med en reproduserbar hastighet (betingelser som vanligvis er oppfylt for flytende forløpere, men ikke for faste stoffer).
3. Ikke selvreagerende eller nedbrytende på overflaten eller i gassfasen (for selvterminerende overflatereaksjoner).
4. Meget reaktiv med den andre reaktanten som tidligere er festet til overflaten, noe som resulterer i relativt rask kinetikk og dermed lavere ALD-temperaturer og syklustider.
5. Flyktige biprodukter som lett kan renses for å forberede seg til den påfølgende halvsyklusen.
6. Ikke-korrosive biprodukter for å forhindre ujevnheter på grunn av filmetsing og korrosjon av verktøyet.
I 2007 innlemmet Intel Corporation HfO2inn i high-k gate dielektrisk stabel ved 45 nm teknologinode. Imidlertid ren HfO2lider av lav-k grensesnittlagproblem med Si, noe som begrenser lavere ekvivalent oksidtykkelse (EOT) verdier. Det krystalliserer også lett ved temperaturer så lave som ~500 grader. Derfor er amorfe dielektriske stoffer med høy termisk stabilitet fortsatt ettertraktet uten iboende defekter (f.eks. korngrenser), forutsatt at de fortsatt tilbyr fordelene med HfO2, slik som høy dielektrisk konstant, stort båndgap og lav lekkasjestrøm. Lantanbaserte ternære oksider, slik som lantanskandate (LaScO3) og lantanlutetiumoksid (LaLuO3), avsatt ved ALD-prosess som involverer metallamidinat-forløpere, viser etter sigende ønskelige strukturelle og elektriske egenskaper. Faktisk LaLuO3er potensielt det beste dielektrikum for amorfe faseport med dielektrisk konstant k~32. Den danner ikke lav-k grenseflatelag med Si som muliggjør effektiv oksidtykkelse (EOT) verdier < 1 nm med betydelig lav lekkasjestrøm. En annen faktor som bidrar til den lave lekkasjestrømmen over ALD dyrket tynn LaLuO3gate dielektrikum er den store båndforskyvningen (2,1 eV) i forhold til Si; de symmetriske lednings- og valensbåndforskyvningene resulterer i like lekkasjestrømmer i elektrondrevne NMOSFET-er og hulldrevne PMOSFET-er. Den forblir amorf og danner ikke legeringer med Si eller Ge etter respektive kilde/avløpsaktiveringsglødninger.

Som et helt nytt eksempel på en applikasjon med høy aspektforhold på 300 mm wafere som krever alle ALD-forløperkarakteristikker beskrevet ovenfor (1 til 6), kan vi se artikkelen som Imec presenterte på denne berømte IEDM-konferansen, om bruk av et LaSiOx-lag som en dipol satt inn i HKMG-stabelen. Imec lyktes i å stable den komplette FinFET-frontmodulen på toppen av en "standard" bulk-silisium FinFET-modul som også demonstrerer god terskelspenningsinnstilling, pålitelighet og lavtemperaturytelse. Antagelig har den mest sannsynlig blitt avsatt ved en ALD-prosess siden den vil måtte belegge finnene konformt og sikre presis tykkelseskontroll og ensartethet: IEDM2018 Paper #7.1, "First Demonstration of 3D Stacked FinFETs at a 45nm Fin Pitch and 110nm Gate Pitch Technology på 300 mm wafers," A. Vandooren et al., Imec.
Som i dette tilfellet og mange flere, setter de strenge kvalifikasjonene for ALD-forløpere dem i kategorien spesialkjemikalier av høy kvalitet - ytelses- eller funksjonsspesifikke materialer eller molekyler du velger. De avsatte filmegenskapene er sterkt påvirket av de fysiske og kjemiske egenskapene til et enkelt molekyl eller en formulert blanding av molekyler samt dets kjemiske sammensetning. Derfor legger det et stort press på produsenten og leverandøren av spesialkjemikaliene med høy renhet når det gjelder kvalitet, renhet, dokumentasjonsprosedyrer, kundeservice etc.
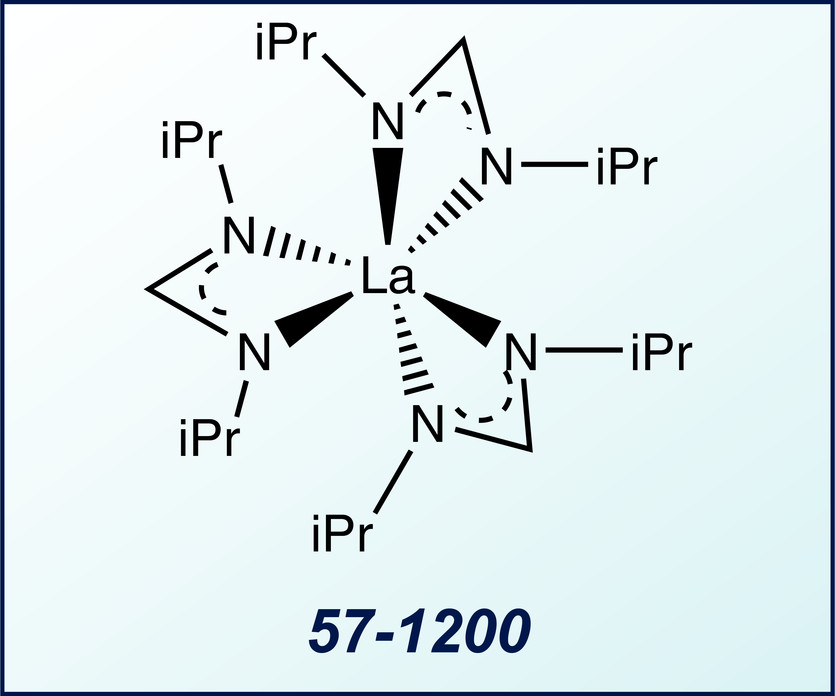
Tris(N,N'-di-i-propylformamidinato)lantan(III), (99.999+%-La) La-FMD er et av metallamidinat-forløperne for La ALD. Materialet er et hvitt til off-white pulver. Den kjemiske formelen og molekylvekten til La-FMD er C21H45LaN6og 520,53, henholdsvis. Rohm and Haas Electronic Materials LLC (senere Dow Chemical) rapporterer La-FMD som den mest flyktige La-forløperen kjent så langt. Damptrykket ved en gitt temperatur gitt av La-FMD er høyere enn det av La(Cp)3og La(thd)3. Dessuten rapporterer Roy G. Gordon fra Harvard University at amidinat-forløperne er termisk mer stabile enn deres amid-motstykker på grunn av den chelaterende amidinatliganden og fraværet av MC-binding. La-amidinater er svært reaktive med Si-H-bindinger som gir mye kortere overflatemetningstid og i sin tur rask selvterminering av ALD-halvreaksjonen; og dermed forkorte ALD-syklustiden. En utmerket overflatedekning er også gitt av La-amidinat-forløpere på Hydrogen-terminert Si.
Opprinnelse fra: https://www.strem.com/catalog/product_blog/160/1/strem_tilbud_nye_la-fmd{{ 7}}ald_forløper_for_fremtidig_ledende_kant_logikk_og{{15} }minne_produkter
